集束イオンビーム(Focused Ion Beam: FIB)は、きわめて細く集束したイオンビームで試料表面を走査する装置です。
イオンビームの走査は、試料表面の観察やスパッタリング、デポジション、エッチング、走査電子顕微鏡(SEM)の断面加工観察や透過電子顕微鏡(TEM)試料作製加工、デポジションによる成膜などに用いられます。精密にイオンビームを照射できる機能を利用し、半導体製造装置用フォトマスクの欠陥部分を補修したり、付加部分を除去したりすることも可能です。このような機能に特化した装置がFIBマスクリペア装置です。
イオン源部ではガリウム液体電金属イオン源と、引き出し電極との間に電界をかけることでイオンを取り出します。取り出したイオンを光学部の高電圧の電界で加速させて試料と衝突させると、二次電子と原子が放出されます。光学部の加速電圧を上げればビームを絞ることが可能ですが、同時に試料へのダメージが大きくなります。そのため一般的には+5kV~+30kVの電圧が用いられます。
松定プレシジョンでは光源部の引き出し電極への電圧印加や、イオンの加速用に使える、低ノイズ高圧モジュール電源や高圧オンボード電源、HSRシリーズやOPTONシリーズなどを取りそろえています。
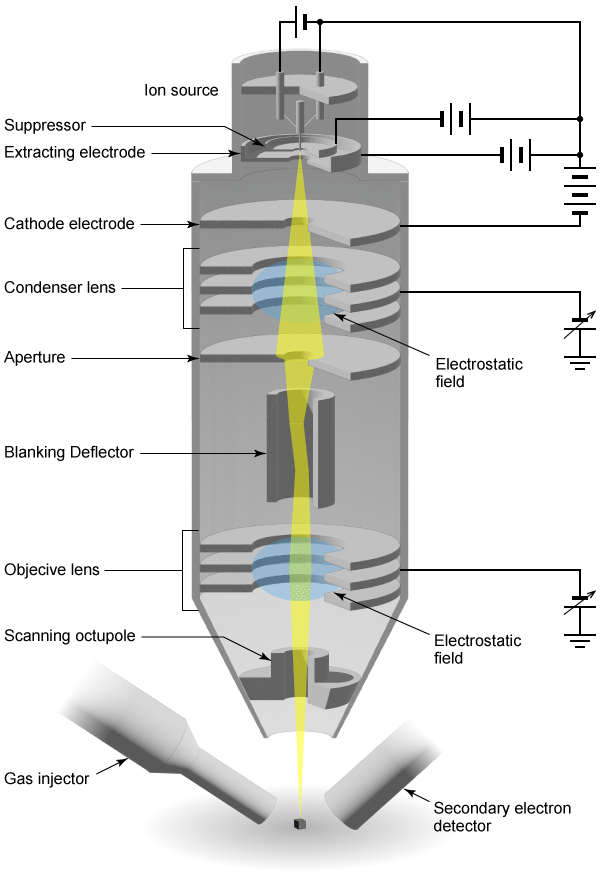
FIB、FIB-SEM装置のメーカー
- サーモフィッシャーサイエンティフィック https://www.thermofisher.com/jp/ja/home/electron-microscopy/products/dualbeam-fib-sem-microscopes.html
- 日立ハイテク https://www.hitachi-hightech.com/jp/ja/products/microscopes/fib-sem/
- 日本電子 https://www.jeol.co.jp/products/scientific/fib/
- ZEISS https://www.zeiss.com/microscopy/ja/products/sem-fib-sem.html
- TESCAN https://ja.info.tescan.com/semicon
- RAITH https://raith.com/products/velion/
- CIQTEK https://www.ciqtekglobal.com/fib-sem-db550_p30.html
FIBの鏡筒(FIB GUN)メーカー
- ORSAY PHYSICS https://www.orsayphysics.com/fib
- Focus GmbH https://www.focus-gmbh.com/ion-sources/
- Kimball Physics https://www.kimballphysics.com/product-category/ion-gun-systems/
- Ionoptika https://ionoptika.com/products/
- ULVAC-PHI https://www.ulvac-phi.com/en/products/ion-gun/fig-5/
- A&D https://www.aandd.jp/products/dsp/eb.html
FIBのイオン源(Gallium liquid metal ion sources: Ga+ LMIS)メーカー
- Applied Physics Technologies (APT) https://www.a-p-tech.com/ion-sources
- Applied Beams LLC https://www.appliedbeams.com/products/fib-sem-consumables/liquid-metal-ion-sources/
- 関連ワード:
関連製品
集束イオンビーム装置のイオン源の引き出し電極への電圧印加や、イオンの加速用に使える、低ノイズ高圧モジュール電源や高圧オンボード電源、HSRシリーズやOPTONシリーズなどを取りそろえています。



 0120-747-636
0120-747-636





